안녕하세요!
이번 글은 Photolithography에 대한 내용에 대해 작성해 보려 합니다!
이부분 강의가 2주분량...(61페이지)였어서 조금 길 것 같아요.
그래서 두 파트로 나누어 진행하려 합니다! 너무 길어서 보기 힘들더라구요ㅠ
(1)에서는 전반적인 photolithography 과정에 대해 알아봅시다!
- 전반적인 과정 Preview

Photolithography에 대한 자세한 내용을 살펴보기 전에, 전반적인 내용은 위와 같습니다.
한줄로 정리하면, "wafer의 surface에 PR을 이용해 mask/reticle pattern의 design을 transfer하는 patterning process"라고 할 수 있습니다!
자세한 내용은 아래에 차차 다루어 보도록 하겠습니다 :)
< Photoresist - PR >
- Major components of PR
우선 PR물질은 빛에 민감하게 반응하는 화학적 compound를 말합니다.
일시적으로 wafer에 coating하여 mask pattern을 transfer시키는 과정에 사용하게 됩니다.
PR의 구성 물질은 다음과 같습니다.
① Resin(or Polymer)
- organic(유기물)로써 Carbon을 가지고, 빛에 반응을 하지 않음.
- 물리적 특성을 결정함.
ⅰadhesion : wafer에 얼마나 잘 붙는지
ⅱ chemical resistance : developer에 녹지 않을 화학적인 저항의 정도
ⅲ viscosity : 점도. 두께의 control 가능한 정도. → 형태 유지&developer에 쓸려가지 않게 하는 역할
- DUV에 PMMA, UV에 novolac resin, negatice PR에 polysoprene rubber를 사용
② Photoactive compound(PAC) (or Sensitizer)
- polymer로써 Carbon을 가지고, 빛에 반응함.
화학적 reaction을 통해 PR의 solubility가 달라짐.
- 종류
ⅰ positive PR
carbon chain이 여러개 교차해 엉긴 상태(cross-linked)에 빛을 받으면 chain이 끊어지며 현상액에 잘 녹게 변화
ⅱ negatice PR
cross-link가 빛을 받으면 chain이 끊저지지 않도록 굳어지게 변화.
③ Solvent
- polymer로써 carbon을 가짐.
- 용액적으로 존재하게 해주며 PR thin film을 만들게 해줌.
PR을 보관하는데 사용하고 빛을 막기 때문에 exposure 전에 반드시 제거해야 함.
- 파장에 대응하는 PR 종류의 변화
UV 대역의 빛은 g-line(436nm) & i-line(365nm) resist를 사용합니다.
주로 포함하는 3가지 재료들은 다음과 같습니다.
ⅰ resin : novolac ⅱ PAC : DNQ ⅲ Solvent
spining과 baking resist가 끝나고 PAC와 resin은 1:1의 비율이 됩니다.

빛에 반응하면서 carbon이 위쪽으로 올라가며 OH기를 생성하여 수용성, 친수성이 됩니다.
DUV 대역에서는 CA(Chemically amplified) resist를 사용하여 sensitivity를 증가시킵니다.
PAG(Photo-acid generator)는 빛에 노출되면 acid(산)로 변환되고, post-exposure bake 후, surface의 열 에너지로 blocking molecule과 반응하게 됩니다.
즉, PAG가 exposure되면 Acid로 변환되고, PEB 후 acid는 polymer의 INSOL을 SOL로 변환시켜 옆 INSOL로 acid가 이동, 옆의 INSOL이 SOL로 변경되며 이러한 과정이 반복되는, chemical amplification을 하게 됩니다.

- Parameters for PR
PR의 6가지 주요 parameter는 아래와 같습니다.
① Sensitivity : 빛에 얼마나 잘 반응하는지. generate에 필요한 minimum energy를 결정
② Resolution : 해상도. patterning resolution에 직결. 높을수록 미세 패턴 가능
③ Contrast : 노광된 부분과 안 된 부분 경계면의 선명 정도
④ Vicosity : 점도. 박막 두께 결정 요소
⑤ Adhesion : OH를 날려주는 정도.
유기용매를 Si에 도포하면 공유결합으로 이루어진 Si 표면의 OH기와 반응하여 dangling bond를 형성하게 되며 친수성이 됨. 따라서 OH기를 없애 문제 발생을 막아야 함.
⑥ Etch resistance : developer에 넣거나 etching할 때, PR이 잘 etching되지 않을 저항력
< Photolithography >
- Photolithographic Process
전체적인 Photolithography과정은 아래 그림과 같이 표현할 수 있고, 각각 세세히 살펴보겠습니다!

(1) Surface preparation (HDMS Vapor prime)

표면을 준비하는 과정으로, 불순물 제거(remove particle), PR adfesion을 촉진시킬 목적을 가집니다.
primer인 HDMS(hezamethyldisilazane)을 가열시켜 수증기형태로 사용해 coating시킵니다.
(2) Photoresist Coating
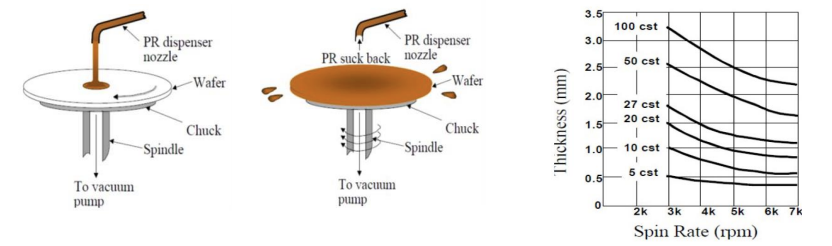
wafer surface에 thin PR film을 deposit하는 과정입니다.
용액의 thickness는 PR vicosity와 wafer spin rat(rpm)과 연관됨을 오른쪽 그래프를 통해 확인할 수 있습니다.
rpm이 클수록 두께는 감소하기 때문에, 용액의 점도가 더욱 중요하게 됩니다.
(ex. 두껍게 제작하기 위해 점도를 20mg/ml -> 40mg/ml로 변경하는 것이 rpm을 3k->5k로 바꾸는 것 보다 더 크게 증가함)
PR은 두꺼울 수록 빛 에너지가 많이 필요하고 spin동안 solvent가 증발하기 때문에, 빠른 진행 과정이 필요합니다.
도포하는 방법은 두가지가 있습니다.
ⅰ static dispense : 멈춘 상태에서 PR을 도포하는 방법.
-> 용액 소모가 높아 빠른 진행 필요, uniformity가 좋음
ⅱ dynamic dispense
-> PR 소모가 적고, uniformity가 낮음
추가적으로 EBR(Edge-Bead Removal)과정이 있습니다.

edge쪽에 몰린 PR로 인해 원치 않은 profile이 나올 수 있기 때문에, 이러한 edge의 PR을 제거하는 과정을 말합니다.
chemiclal(solvent사용)와 optical(LED) 방법 두 가지가 존재합니다.
(3) Soft Bake (or Pre-Bake)

본격적인 공정을 하기 위해 solvent를 제거하고 PR의 adhesion을 증가시키기 위해 pre-bake를 진행합니다.
온도(temperature)와 시간(time)이 중요한 parameter가 되는데, 두 가지 상황을 가정해 볼 수 있습니다.
- underbaking (time↓, temp↑) : PR이 전체적으로 제거되고 solvent가 남아있어 resolution에 영향을 끼침
- overbaking (time↑, temp↓) : sensitivity가 감소(너무 큰 에너지로 딱딱해짐)되고 CA(chemical amplification) PR에서 화학적 반응이 부족해 under development가 발생할 수 있음
즉, 적당한 온도와 시간을 가해주어야 합니다.
baking방법에도 2가지 존재합니다.

1) convention oven (왼쪽 그림)
- batch type으로 여러장 동시 진행 가능
- N2 gas 순환 시켜 온도를 유지시킴
- 기체가 표면을 때려 가열할 때 crust(PR 조각)가 만들어질 수 있음.
2) Hot plate (오른쪽 그림)
- single-type으로 한장 씩 사용함
- 아래에서 가열하므로 crust 발생X
- 균힐한 heating이 가능
- in-line system이기 때문에 시간적으로 오래 걸림
(4) Alignment and Exposure
mask의 image를 transfer하는 과정으로, 아래와 같이 다양한 요소들을 필요로 합니다.
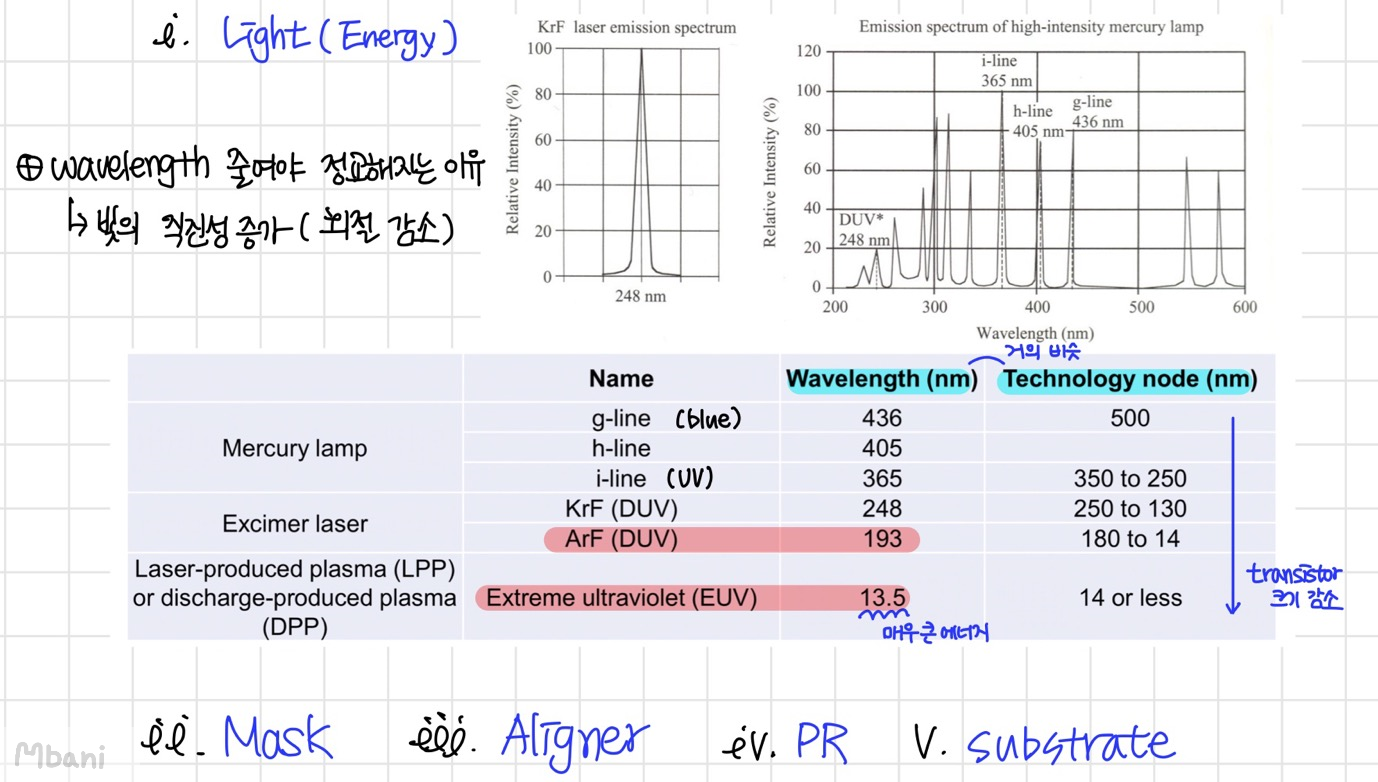
mask의 pattern을 wafer에 printing하는 기술에는 3가지가 있고 아래 그림과 같습니다.
각각 장단점이 존재하고, 현재는 projection printing을 많이 사용하고 있습니다.

Alignnment는 mask pattern과 wafer pattern을 같게 맞추어 주는 과정을 말합니다.
Alignment key를 맞추어 사용하게 됩니다.

이 align을 잘 맞추어야 원하는 동작을 하는 wafer를 형성할 수 있습니다.
exposure하는 방법에는 stepper와 scanner 두 가지 방법이 있습니다.

projection printing에서 mask보다 작은 reticle을 사용하는 방법에서 사용하는데,
stepper는 위치를 맞추어 한 die씩 노광하고, scanner는 지속적으로 움직이며 scan하여 노광하게 됩니다.
추가적으로 mask는 전체 wafer를 노광하는 과정이고, reticle은 die 하나씩을 노광하는 과정입니다.
이때 사용하는 pattern mask/reticle은 Quartz lime glass로 높은 투과율을 가진 물질에 빛이 통과하지 않는 Cr을 사용해 만듭니다.
(5) Post-Exposure Bake (BEB)
PEB는 thermal movement를 통해 standing wave effect(interface effect)가 발생하는 edge를 averaging, smoothing시켜, 해상도를 높여주기 위해 진행하는 과정입니다.

물질의 특성이 망가지는 온도 이상에서 짧게 진행(1 min, 110~130℃)합니다.
물론 soft bake보다 높은 온도에서 진행하죠.
이 과정은 development과정 이전에 cooling dowm이 필요합니다.
이러한 PEB에서도 두 상황이 가정되는데,
- underbaking : standing wave pattern 발생할 수 있음
- overbaking : development에 영향끼칠 수 있음
즉, 온도와 시간, cooling down이 중요한 parameter가 되겠습니다.
standing effect를 줄이기 위해서
ⅰ. ARC(Antireflective coating)으로 빛이 반사되지 않게 wafer surface에 coating
ⅱ. BARC(Bottom ARC)로 organic을 coating하여 반사 막음
과 같은 방법으로 반사되는 빛의 양 자체를 줄여 wave의 간섭을 막아 줄일 수 있습니다.
(6) Development
원치않는 PR을 지워 pattern을 만드는 Development 과정입니다.

develop -> rinse -> dry의 과정을 따라 진행하게 됩니다. 사용되는 PR에 따라 지워지는 곳이 달라지죠.
ⅰ. positice PR : 노광된 부분을 carboxylic acid로 바꿔 alkaline developer에 쉽게 녹게 함.
ⅱ. negative PR : 노광되지 않은 부분을 xylene에 strip시킴.
developer는 spin coater로, rinse는 DI water를 사용하고, spin dry와 온도 가열로 완전히 이들을 제거시킵니다.
(7) Hard Bake
Hard Bake과정은 다양한 목적을 가집니다.
1. 표면에 남은 용액들을 날려 다음 process를 준비합니다.
2. PR etch resistance(SiO2 etching할 때 PR 날라가지 않을 저항성)과 implantation resistance(implantation될 때 PR은 되지 않을 저항성)을 향상시켜 더욱 단단한 저항을 만들기 위해 진행합니다.
3. adhesion을 향상시켜 원하는 profile을 정확히 나타내기 위해 PR을 물리적으로 단단히 붙어있게 합니다.
위 목적을 가지고 oven 또는 hot plate에서 baking을 진행합니다.
oven : 20-30min, 120-180℃ (고온에서 오래)
hotplate : 1-2min, 100-130℃ (상대적 저온에서 짧게)
soft bake와 PEB보다 높은 온도에서 bake를 진행하게 됩니다.
Hard bake에서도 두 가지 상황이 진행될 수 있습니다.
- underbaking : PR etch rate 증가, adhesion 매우 감소
- overbaking : PR overflow로 resolution 안좋아짐.
(8) Metrology and Inspection
PR pattern이 잘 형성되었는지, 원하는 etching이 되었는지 확인하는 과정입니다.
원하는 것과 다르면, PR 모두 strip, photolithography과정을 재시작하면 됩니다.
PR pattern은 일시적이지만, Etch와 implantation pattern은 영구적이기 때문에 미리 PR에서 바로잡는것이 중요합니다.
- Optical and Electron Microscopy
PR이 제대로 patterning되었는지 확인하기 위해 다양한 전자 현미경을 사용합니다.

overlay measurement는 모든 photolithography step마다 필요하기에 align key를 사용합니다.
misslignment가 버틸수 없는 한계에 도달하면 그 device는 실패하게 되기 때문에,
원하는 frame인 tolerance limit 안에 pattern이 존재해야 합니다.
그리고 원하는 구조가 형성되었는지 확인하는 CD measurement가 있습니다.

CD는 critical dimension으로 IC에서 minimum feature size인 line width, spacing, contact dimension을 확인하게 됩니다.
이 과정은 fine pattern을 측정하기 위핸 metrology system인 CD-SEM을 통해 확인할 수 있습니다.
이러한 기준은 LER과 LWR로 확인할 수 있습니다.
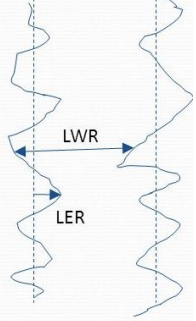
LER(Line-edge roughness)는 원하는 pattern line에 얼마나 벗어났는지를 확인하는 것이고,
LWR(Line-width roughness)는 원하는 pattern의 line과 line사이의 길이를 확인하는 것 입니다.
각각은 lithography(standing wave)와 ethching(chemical)로 발생합니다.
poly-gate pattern에 이러한 상황들이 발생하면 channel에도 영향을 끼치기 때문에, off current가 증가, Vt 변화가 증가하며 원치않는 transistor동작을 하게될 수 있으니 이를 잘 해결해야 합니다.
- Lithography Trends

사용하는 빛의 파장이 감소하면서 resolution의 향상이 같이 발생하게 됩니다.
즉, channel의 크기가 감소하고 device의 크기도 감소하게 되었죠.
photolithography는 한계에 도달하였고 이젠 patterning기술을 발전시켜 PET와 같은 여러 기술들로 진행되고 있습니다.
오늘 내용은 여기까지입니다!
(2)편에 이어서 DOF와 Resolution에 대해 이야기 해볼게요!
부족한 내용이지만 도움이 되셨으면 좋겠습니다 ㅎㅎ

'[학부 일기] 전자공학과 전공 > 반도체 공정 및 응용' 카테고리의 다른 글
| [반도체공정및응용] Oxidation (1) | 2023.02.22 |
|---|---|
| [반도체공정및응용] Photolithography (2) (0) | 2023.02.06 |
| [반도체 공정 및 응용] Wafer&Cleaning (0) | 2023.01.09 |
| [반도체 공정 및 응용] CMOS Process Flow (0) | 2022.12.25 |
| [반도체 공정 및 응용] Semiconductor Fabrication & Applications (0) | 2022.12.18 |