이전 게시글과 이어집니다!
Day 1 ) 전체적인 fabrication 과정에 대한 이론 수업과 poly-Si LPCVD 까지의 실습
< 실습 과정 >
1. Spin coating & Soft bake
(1) 동선
- photolithography 과정은 매우 중요한 과정이기 때문에 동선과 방법을 잘 기억해야할 필요가 있음!

(2) 과정
① filter paper와 트위져를 가지고 Singe(Oven)으로 이동. 트위져는 Spin coating 장비에 얹어둠.
(Singe에서는 HDMS약품을 사용해 전처리를 진행 -> 척수성표면으로 substrate와 PR의 접착력 향상)
② Singe(Oven)에서 wafer를 꺼냄. (내부 wafer가 깨질 수 있으니 문은 살살 닫아야 함)

③ wafer를 spin coating 장비로 옮김.
wafer를 두세번 흔들어 coating이 잘되게 자체의 온도를 낮춰줌
④ spin coating 장비 내부에 검정색 chuck 위에 wafer를 놓음
트위저 뒷부분으로 wafer와 chuck의 중심을 맞추고 vacuum 스위치로 고정시킴
wafer 위의 dust를 없애기 위해 바람을 형성해줌

⑤ 검은 화학병 속의 PR의 스포이드를 적당량 덜어 wafer의 가운데에 뿌려 퍼지게 진행
(PR 병의 위치는 반드시 제자리에 두어야함)

⑥ 뚜껑을 덮고 spin coating 시작 버튼을 누름. rpm=30초, PR THK=7200A로 진행
⑦ coating 후 뚜껑을 제자리에 손잡이가 수직방향으로 내려놓고, vacuum을 제거시켜 고정을 품
트위져의 뒷부분으로 wafer를 1사분면->3사분면으로 밀어 수평으로 wafer를 잡아 paper로 이동시킴
(primary flat zone 기준(길게 평평한 부분)으로 3시, 9시 부분은 절대 잡으면 안됨. -> align key가 놓일 부분)
⑧ soft bake 진행 -> hot plate 위에 wafer를 얹어 1m30sec bake 진행


2. Exposure & PEB
- active mask의 pattern을 옮기기 위해 exposure 진행


- flat zone이 아래로 잘 향하게 wafer를 두어야 하고 이때의 기준을 토대로 align이 이후 과정에서 필요
- mask pattern을 올린 후 UV light를 조사해 빛을 받은 부분의 PR의 결합력을 떨어뜨림
=> PR은 positive PR을 사용하였기 때문


- PEB를 통해 standing wace에 의한 수직방향 PR의 굴곡을 제거시킴

3. Develop
① wafer를 developer에 전체적으로 담구고 원하는 pattern이 형성된 것 처럼 보이면 빼냄
( 약 3-4초 정도. 더 오래 있으면 작은 pattern이 없어질 수 있음 )
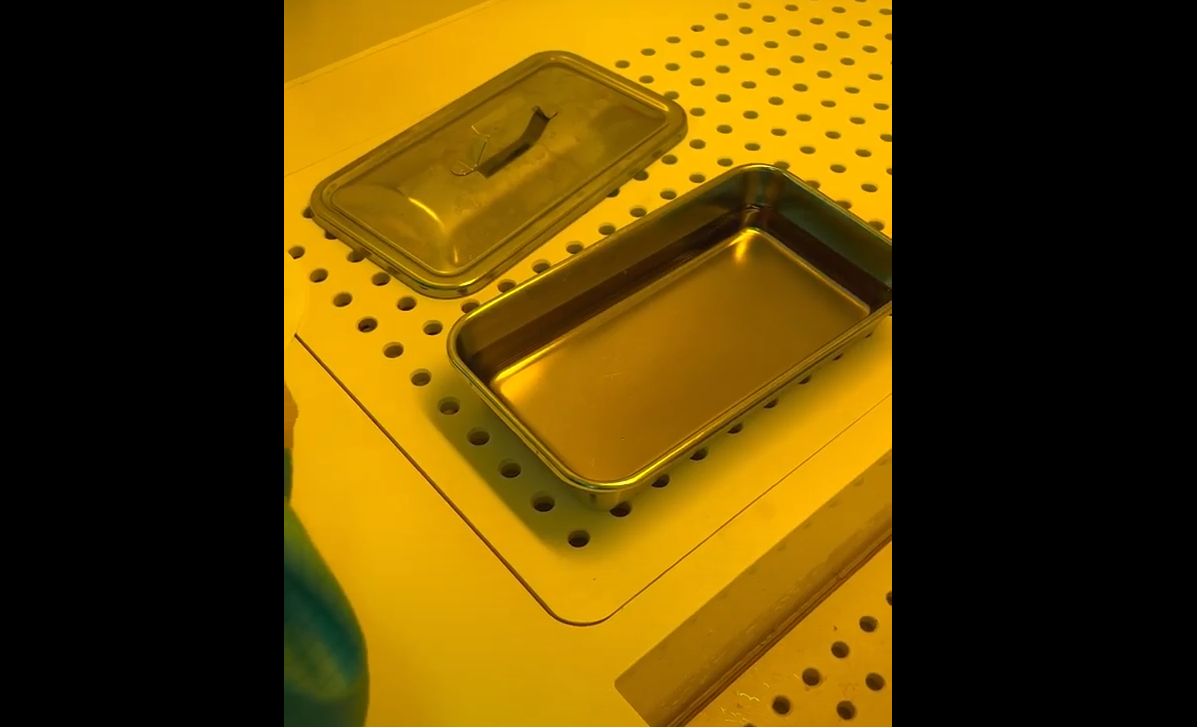
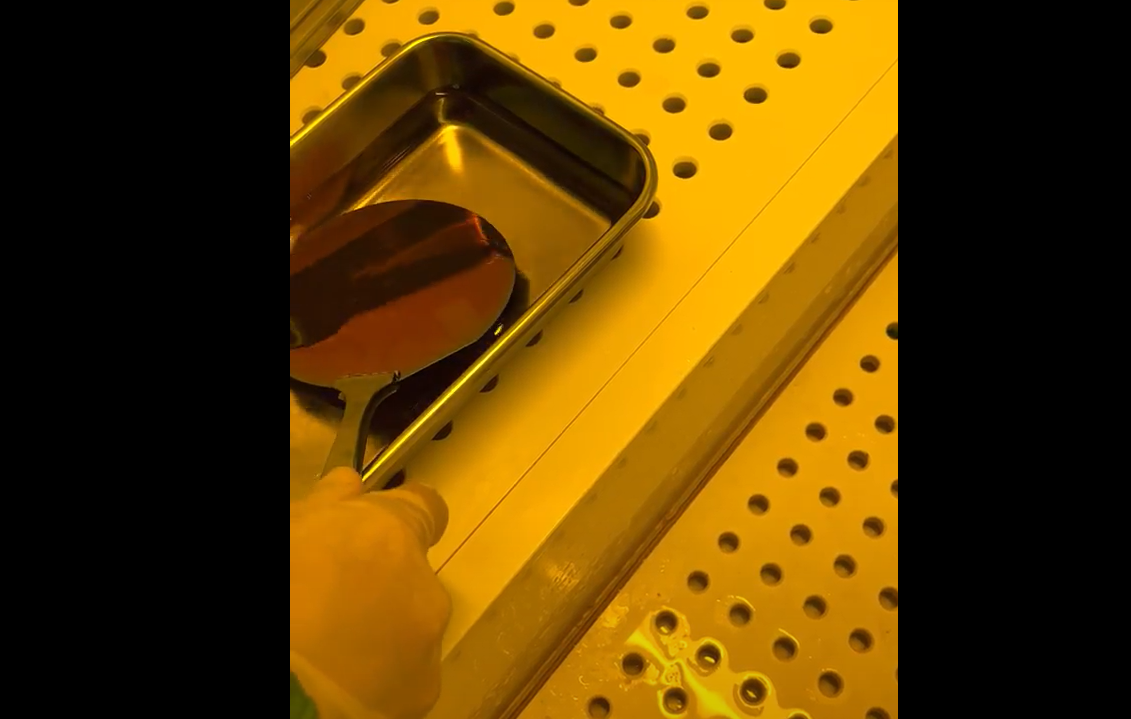
② water에 넣어 developer를 씻어내고 water gun으로 완벽히 씻어냄


③ N2 gas gun을 통해 물기를 없앰.
( wafer를 기울이고 안에서 바깥으로 밀어냄. 전면의 물기를 제거해야 색 굴절 왜곡이 없음 )

4. Inspection & Hard bake
① develop을 진행할 wafer를 현미경에 두고 Z축을 조절하여 해상도를 맞춤

② 붉은 색을 띄는 곳이 PR, 흰색은 develop로 녹은 부분.
얼룩이 져있다면 develop이 덜 되었다는 것.
( 얼룩을 지우기 위해 develop을 다시 진행하면 미세패턴이 없어질 수 있음. => trade off 관계 )

③ hard bake를 진행 (110℃, 3min)
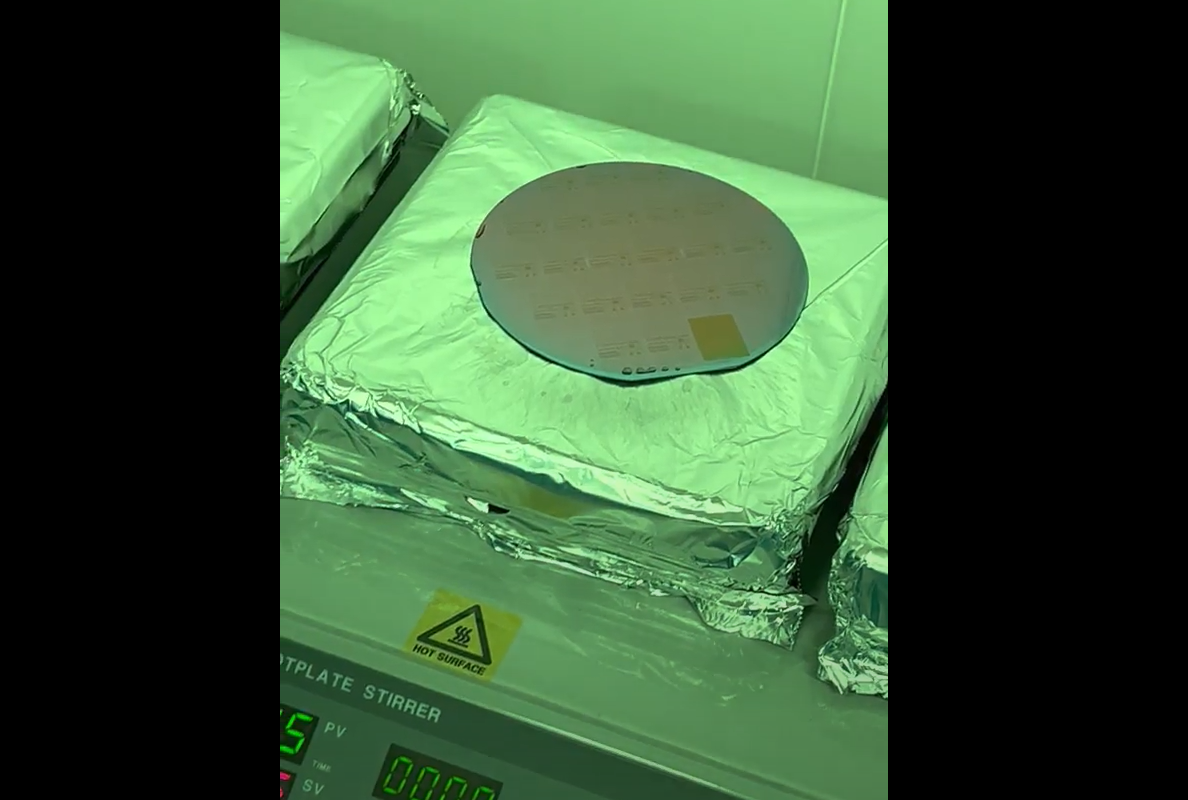
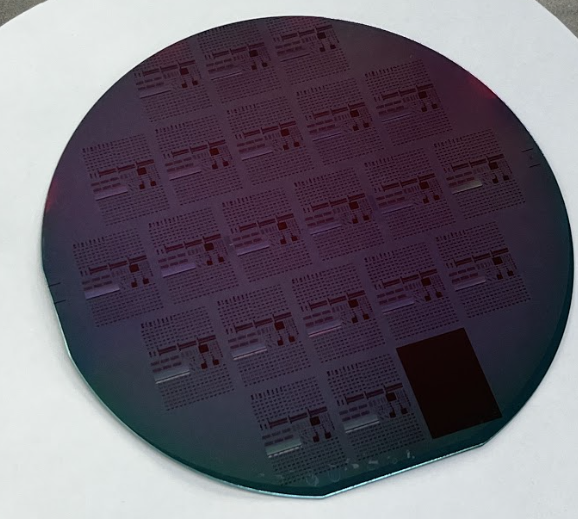
저희가 진행한 wafer는 처음 PR coating 시 미세한 particle들이 보였고 후 과정에 영향을 끼칠까 걱정을 조금 했었습니다.
이후 develop를 진행하고 inspection을 진행했을 때, 얼룩이 없었고 particle도 매우 미세하게 적어서 잘 된것 같았네요!
+ Photo 과정 후 다른 조들과 색을 비교했을 때 저희 조는 붉게 보였지만 파랗게 보이는 조도 있었습니다.